‘꿈의 패키징’ 개발 중인 SK
12일 업계에 따르면 SK하이닉스는 내년 양산 예정인 HBM4의 본딩 방식을 기존 ‘MR-MUF’(Mass Reflow-Molded UnderFill)와 하이브리드 본딩의 투트랙으로 개발하고 있다.
|
본딩은 반도체 사이의 접착 공정을 말한다. HBM은 D램을 쌓아서 만든 제품인데, MR-MUF는 먼저 열을 가해 일종의 납땜 작업을 한 이후 칩 사이에 끈적한 액체를 넣어 단단하게 굳히는 방식을 말한다. 동시에 칩을 보호하는 껍데기 마감 작업인 ‘몰딩’을 함께 진행한다. 이때 D램 사이에는 ‘범프’(공 모양의 전도성 돌기)라는 소재로 이어붙인다. 그런데 하이브리드 본딩은 D램 사이에 넣는 범프 없이 D램을 바로 연결하는 기술이다. 이를 적용하면 범프를 없애 HBM 두께를 획기적으로 줄일 수 있고, D램 사이의 거리가 가까워져 데이터 전송 속도가 빨라질 수 있다. 기존 본딩 방식의 약점을 획기적으로 메운 방식인 만큼 주요 고객사들의 관심이 큰 것으로 알려졌다.
특히 국제반도체표준화기구(JEDEC)는 최근 HBM4 표준으로 이전 세대인 720마이크로미터(㎛)보다 두꺼운 775㎛로 두께를 완화했다. 이를 액면 그대로 받아들이면 메모리 기업들 입장에서는 기존 본딩 방식으로 HBM4를 구현할 여유가 생겼다는 해석이 가능하다. 현실적으로 당분간 MR-MUF와 하이브리드 본딩을 함께 검토하는 체제로 갈 수 있다는 뜻이다.
HBM 판 뒤집기 노리는 삼성
삼성전자는 16단 이상 HBM 제품에서는 하이브리드 본딩이 필수적이라는 입장을 외부에 피력해 관심을 모았다. 최근 미국 콜로라도주 덴버에서 열린 전자부품기술학회(ECTC)에서 이같은 논문을 내놓으면서다. JEDEC의 두께 표준 완화와 상관 없이 하이브리드 본딩을 경쟁사보다 빨리 성공시켜 1위로 올라서겠다는 복안인 셈이다. 추후 24단, 32단 등의 제품까지 염두에 두면 하이브리드 본딩은 필수라는 것이다.
이는 삼성전자의 추격을 받는 SK하이닉스가 하이브리드 본딩 개발 속도전을 펼 유인으로 작용할 전망이다. 최태원 SK 회장은 이번달 초 SK하이닉스 본사인 이천캠퍼스를 찾아 “6세대 HBM을 내년에 조기 상용화하자”는 메시지를 임직원들에게 던졌다. 이 언급은 하이브리드 본딩 기술까지 포함한다는 게 업계 시각이다. 실제 SK하이닉스 고위 인사들은 공개석상에서 하이브리드 본딩 패키징 기술을 부쩍 입에 자주 올리고 있다.
메모리 3위인 마이크론 역시 HBM4를 염두에 두고 하이브리드 본딩 연구에 한창이다. 다만 삼성전자, SK하이닉스보다는 상대적으로 덜 성숙했다는 게 업계 관측이다. 업계 한 관계자는 “마이크론은 현재 쓰고 있는 TC-NCF 방식을 당분간 유지할 것으로 본다”고 했다.


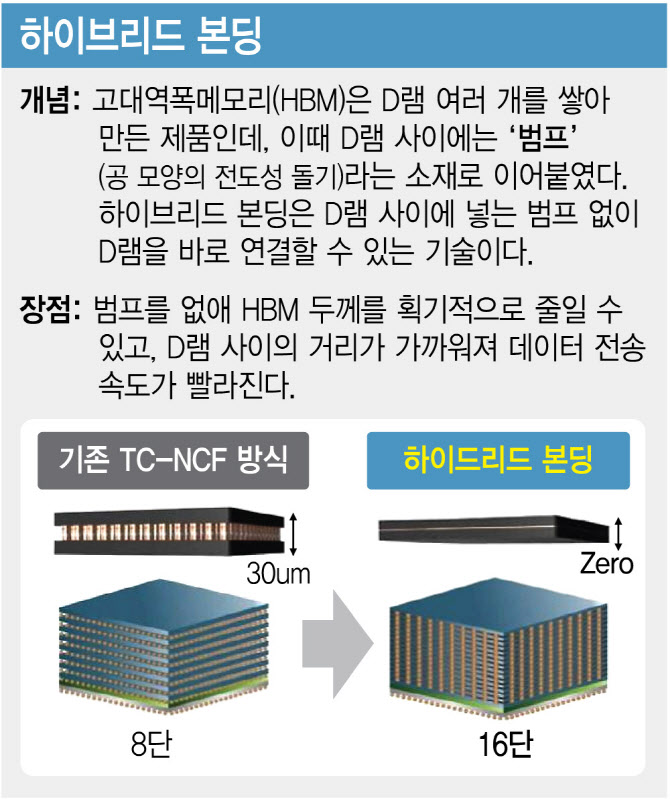






![[포토] 이즈나 데뷔](https://spnimage.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500181t.jpg)
![[포토]첫 싱글 '라스트 벨'로 돌아온 TWS](https://spnimage.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500118t.jpg)
![[포토] 의원들과 인사나누는 이재명 대표](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500985t.jpg)
![[포토] 2024 개발협력의 날 기념촬영](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500978t.jpg)
![[포토]안전운임제 확대 촉구](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500923t.jpg)
![[포토]허정무 ‘축구협회는 다시 태어나야’](https://spnimage.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500080t.jpg)
![[포토]가을의 절정](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500677t.jpg)
![[포토]스테파니 린, 리서치 헤드, 기업거버넌스포럼](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500657t.jpg)
![[포토] 김재홍 국립중앙박물관장, 상형청자 특별전](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500648t.jpg)
![[포토]가슴 뛰는 통일 대한민국을 위하여](https://image.edaily.co.kr/images/Photo/files/NP/S/2024/11/PS24112500462t.jpg)



!['유동성 위기설' 롯데그룹…‘마지막 금융사’ 캐피탈 매각 나서나[마켓인]](https://image.edaily.co.kr/images/vision/files/NP/S/2024/11/PS24112501420h.jpg)
